查看更多
低频双模式技术破解纳米薄膜加工难题
在纳米技术飞速发展的今天,薄膜刻蚀深度已迈入几纳米到几百纳米的精细范畴,甚至石墨烯逐层刻蚀需小于 1 纳米的精准控制。传统高频反应离子刻蚀设备复杂且成本高昂,而低频 “双模式” 等离子体技术的出现,为超薄层刻蚀提供了更优选择。
一、低频双模式:超薄层刻蚀的核心优势
对于厚度小于 1 微米的薄膜,20~100kHz 低频发生器的等离子体设备能完美适配刻蚀需求。相比传统 13.56MHz 高频设备,它在保证刻蚀效果的同时,大幅简化了匹配网络与冷却系统,降低了设备复杂度和使用成本,成为科研与工业生产中极具性价比的选择。
二、双模式解析:两种工艺,灵活切换
容性耦合等离子体(CCP)的 “双模式” 指 PE 模式与 RIE 模式,用户可根据工艺需求自由选择,且能在单一配方中无缝切换,无需中断流程。
1. PE 模式(等离子体刻蚀模式)

又称“反应性中性主导” 模式,样品装载在电接地电极上,几乎无离子轰击。
典型应用包括光刻胶灰化、等离子体增强化学气相沉积(PECVD)及多数表面改性工艺。
2. RIE 模式(反应离子刻蚀模式)
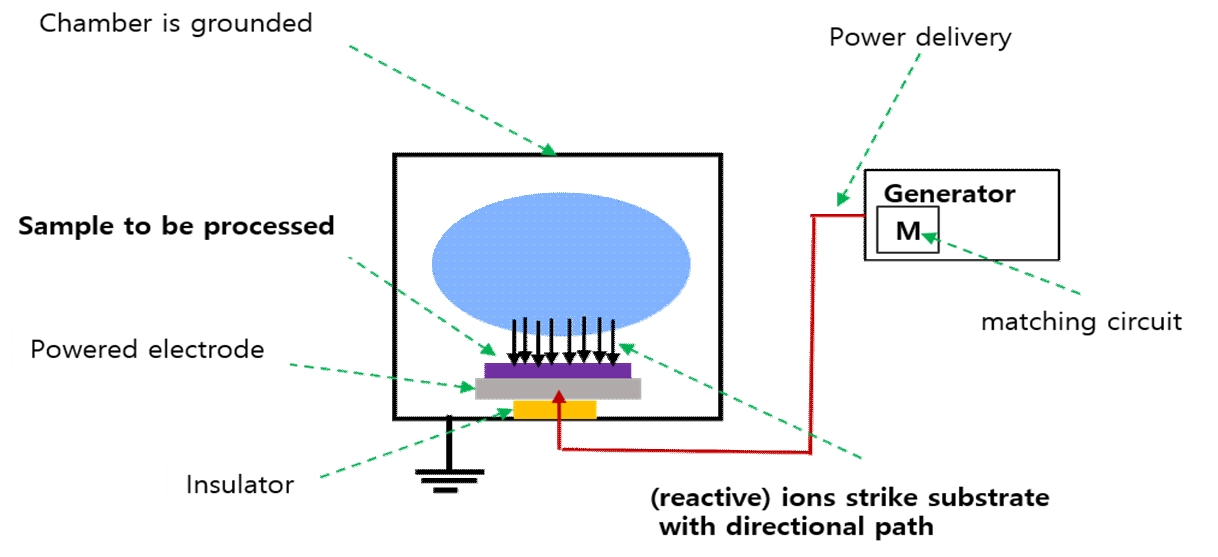
即“反应性离子主导” 模式,样品放置在加电电极上,高能离子轰击可提升刻蚀速率。
作为最广泛应用的刻蚀工艺,适用于各类薄膜的精准去除。
Femto Science Inc. 的 CUTE 与 COVANCE 系列科研级设备,正是凭借双模式功能,成为亚纳米至数百纳米级薄膜加工的高效工具,兼顾空间利用、设备管理与成本控制三大优势。
三、实测验证:两大参考工艺的优异表现
工艺 1:SiO₂刻蚀(RIE 模式)
样品规格:4 英寸晶圆,3000Å PECVD 氧化层,1um 厚负性光刻胶,开口面积 29.43%。
工艺条件:本底压力 80mTorr,工艺压力 200mTorr,100% CF₄气体,80W@50kHz 功率,刻蚀 15 分钟。
核心结果:刻蚀速率达 10nm/min,光刻胶选择比 1:1,刻蚀效果均匀精准。
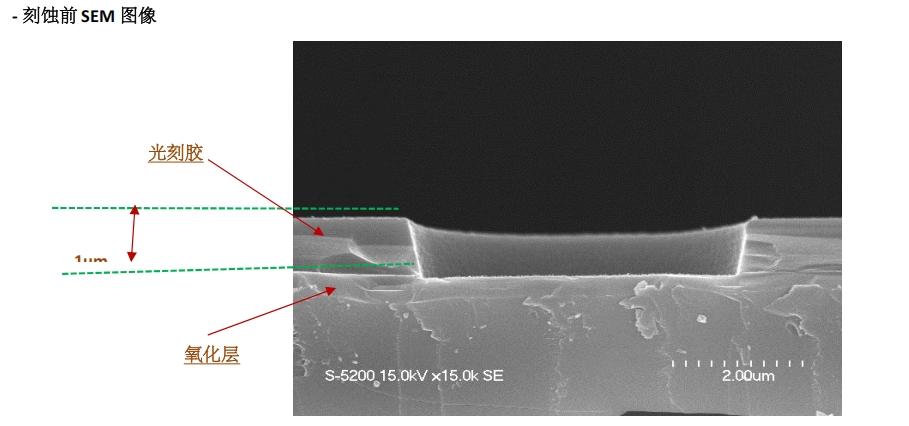
工艺 2:聚对二甲苯刻蚀(RIE 模式)
样品规格:4 英寸晶圆,2.2um 厚 SU8-2002 光刻胶,C 型聚对二甲苯层,应用于生物传感器。
工艺条件:本底压力 80mTorr,工艺压力 500mTorr,100% O₂气体,80W@50kHz 功率。
核心结果:刻蚀速率超 150nm/min,高效满足生物传感器的加工需求。
四、设备参数参考
*刻蚀速率会因负载效应、刻蚀形貌等条件而变化
*标准工艺设置为500mTorr, 80w, 50kHz, 反应离子刻蚀(RIE)模式。
低频双模式等离子体技术以其灵活切换、成本可控、刻蚀精准的优势,正在纳米薄膜加工领域占据重要地位。无论是科研实验中的精细刻蚀,还是工业生产中的高效加工,都能提供稳定可靠的解决方案。
关注我们了解更多内容
Femto Science中国授权经销商:
上海迹亚国际商贸有限公司
Gaia China Co.,Ltd.
电话:13818732961/18201779599
邮箱:info@gaiachina.com.cn
网址:http://www.gaiachina.com.cn
地址:上海市闵行区七莘路108广场南楼2705室

 中国/China
中国/China 新加坡/Singapore
新加坡/Singapore 马来西亚/Malaysia
马来西亚/Malaysia 印度尼西亚/Indonesia
印度尼西亚/Indonesia

















